多指条GGNMOS抗ESD设计技术
利用多指条nMOSFET进行抗ESD设计是提高当前CMOS集成电路抗ESD能力的一个重要手段,本文利用TLP(Transmission Line Pulse)测试系统,测试分析了其nMOSFET单管在ESD作用下的失效机理,计算了单位面积下单管的抗ESD (Electro Static Discharge) 能力,得到了为达到一定抗ESD能力而设 计的多指条nMOSFET的面积参数,并给出了要达到4000V抗ESD能力时的最小面积。
ESD 作用下的nMOSFET工作机理
栅极接地nMOSFET(ggnMOS)是构成ESD保护电路的一个重要组成部分,设计良好的ggnMOS不仅可以为内部电路提供基本的ESD保护,而且可以与其余电路单元一起组成稳定有效的ESD保护电路,保证电路的ESD 可靠性。表征ggnMOS抗ESD能力的一个重要参数是其二次击穿电流 It2。
图1(a) 是一个nMOSFET及其寄生的横向npn晶体管示意图,其中Rsub为衬底电阻;图1 (b) 是在ESD 作用下ggnMOS的典型TLP I-V特性曲线,其中 Vt1/It1 为开启电压/电流,Vh为维持电压, Vt2/It2 为二次击穿电压/电流。
当在漏极和VSS之间施加一个正向ESD脉冲应力时,漏电压上升直至反偏的漏/衬底(n+/P-)结发生雪崩击穿,衬底电位升高直至横向npn管开启(Vt1),ggnMOS进入负微分电阻区。这样ESD应力产生的大电流就由寄生的双极晶体管承担了,通过寄生的双极npn晶体管,ESD产生的电流被泄防到地,有效地保证了内部电路的安全性。若电流继续上升超过寄生晶体管的二次击穿电流(It2)就 会发生二次击
穿,二次击穿是热击穿,一旦发生二次击穿,器件就会受到损伤,二次击穿电流反映了器件的ESD强度。

图1 (a) NMOS 晶体管及 其寄生横向npn管,
(b) nMOSFET’s 的典型I-V特性曲线。
从图 1 (b) 可以看到,当 ESD 电压超过寄生 npn 管的开启电压 Vt1后,nMOSFET 进入负微分电阻区,电压保持在维持电压 Vh,同时为 ESD 电流提供泄放回路,如果ESD 电流超过了晶体管的二次击穿电流 It2,晶体管就会被击穿烧毁。因此为了得到良好的 ESD 能力,通常需要的就是降低Vt1和增加It2,增加 It2最常用的方法是增加面积(采用多指条晶体管),其结构就相当于多个单指条的nMOSFET并联在一起。
nMOSFET 的 ESD设计
为了得到需要的抗 ESD 水平,同时又不过多的占用芯片的面积,首先针对需要投片的foundry设计了一个标准的nMOSFET单元作为ESD测试结构,其宽长比为10/0.6,该管采用单指条设计(图2 (a)),图 2 (b) 是利用TLP测试该管大电流下的典型I-V特性曲线,从图中可以看到,该管的开启电压(Vt1=8.3V)小于二次击穿电压(Vt2=9.0V), 也就是说这种结构的单管 ggnMOS 并联构成多指条晶体管时在大电流的情况下可以保证各指条均匀导通,这样在通常情况下利用增大面积提高抗ESD 能力的时候就不需要改变单管单元的版图结构,只需要将单管并联就可以得到更高的抗ESD能力,多个这种结构并联在一起可提高整体的抗 ESD 能力而不用担心非均匀触发的问题,因为在单个结构进入二次击穿之前其余的结构已经开启了。
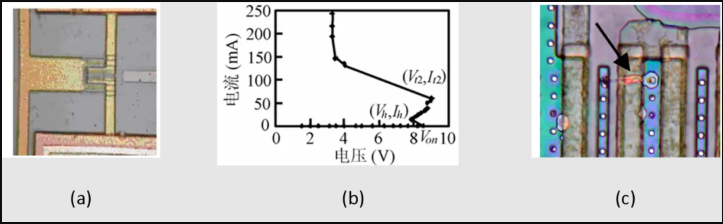
图2 (a) 单指条 nMOSFET单管,(b) TLP 测试得到的 nMOSFET 单管典型I-V特性, (c) 多指条晶体管 ESD 作用下单个指条源漏穿通。
多指条nMOSFET要达到设计的抗ESD能力,必须要保证各个指条均能导通,共同承担泄放ESD 大电流的任务。如果只有一根指条导通,多指条nMOSFET 的作用就等同于单指条的 nMOSFET,其抗ESD能力将大幅降低。通常,当ESD应力作用于多指条nMOSFET时,首先多指条nMOSFET 中的任意一根指条触发导通,进入负微分电阻区,开始泄放ESD大电流,电压缓慢回升。如果nMOSFET 的单指条二次击穿电压(Vt2)小于开启电压(Vt1),在ESD应力触发其余指条之前,该指条已经进入二次击穿区,造成器件失效,不能达到设计的ESD强度(如图2 (c) 所示);如果单指条二次击穿电压(Vt2) 大于开启电压(Vt1),在已触发的指条进入二次击穿之前,ESD应力引起的电压将再次超过nMOSFET 的开启电压,第二根指条被触发,与第一根指条一起泄防ESD大电流,这样进行下去,直至整个 nMOSFET 导通。要达到设计目的, nMOSFET 二次击穿电压必须大于其触发开启电压。
从上面的分析可以看到,nMOSFET的抗ESD强度是由其寄生横向npn 晶体管决定的。对确定的ESD耗散功率而言,横向npn的工作依赖其电流增益(β)、雪崩倍增因子(M)及衬底有效电阻(Rsub),对于ggnMOS, 在自偏压模式下,横向npn的电流增益与开启电压(Vt1)和维持电压(Vh) 之比成正比。横向npn导通时,M、β 和Rsub由下列各式确定:

ID是漏极电流,Isub是衬底电流。Rsub主要衬底掺杂浓度及衬底接触的位置等工艺参数决定,在 设计中很难改变,因此,要提高nMOSFET的抗ESD强度,重点需要考虑M和β的影响。对确定的 ESD的电流,较小的雪崩倍增因子以及较大的电流增益可以得到更好的抗ESD强度,这是因为雪崩倍 增因子越大,产生的电场越高,局部温度就越高,nMOSFET就越容易损坏。
从典型的大电流I-V特性上还可看到该管的二次击穿电流为60mA左右,也就是说单位长度上的二次击穿电流为6mA,从二次击穿电流与抗ESD能力的关系式 V = It2 × R 可知,要达到4000V的抗ESD 能力,此种结构的nMOSFET面积至少应为444µm(其中R取标准人体模型电阻1500Ω),考虑其它因素和余量,取最小面积为500µm。


